芯片在灌膠(jiāo)機中應用
芯片級封(fēng)裝(zhuāng)是繼TSOP、BGA之後內存上的新(xīn)一代的(de)芯(xīn)片封裝技術。半導體技術的進步大大提高了芯片中的晶(jīng)體(tǐ)管數量和功能,這一集成規模在幾年前還無(wú)法想象。下(xià)麵,葡萄视频要說(shuō)的(de)是灌膠機、灌膠機之於芯片級封裝中的應用。
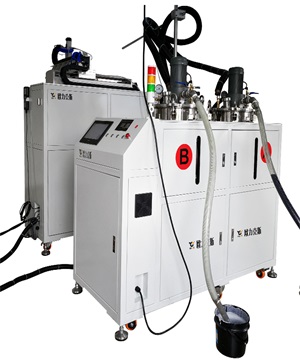
灌膠(jiāo)機在在(zài)芯片(piàn)級封裝中的應用早已不是先例。像手提電子設備中的 csp 器件就是灌膠(jiāo)機(jī)、灌膠機的應用的一個重要分支(zhī)。那麽在芯片級(jí)封裝中應用灌膠機、灌膠機的過程中又應當注意哪些(xiē)事項呢?
在焊接連接灌的時候最好是使用底(dǐ)部填充工藝粘接 csp 器件(jiàn),底部填充(chōng)工藝會使得其性能變得更加可靠。在高產能的(de)電子組裝過程中(zhōng)需要高速精確的灌膠。在許多芯片級(jí)封裝的應用中,同時灌膠係統必須根據膠體的使用壽(shòu)命對材料的粘(zhān)度變化而產生的膠量變化進行自動補償。
在灌膠過程中重中之重就要控製的就是出膠量,出膠(jiāo)量的多(duō)少影(yǐng)響著灌(guàn)膠(jiāo)質量,無論是膠量不夠還是膠量過多,都是不可取的。在影響灌膠質量堵塞同時又會造成(chéng)資源浪(làng)費。在灌膠過程中準確控製灌膠量,既要起(qǐ)到保護(hù)焊球(qiú)的作用又不能浪費(fèi)昂(áng)貴的包(bāo)封材料是(shì)非常關鍵的。

同類文章推薦
- 灌膠(jiāo)機(jī)適用(yòng)於哪(nǎ)些液體(tǐ)?
- 灌膠機與點膠機主要區別是什麽?
- 如何有效而快速的排除膠閥的問題
- 環氧(yǎng)樹脂灌封常見問題
- 點火線圈灌膠機
- 購買灌膠機時需要注意哪些問題(tí)
- 灌(guàn)膠機是什麽?都用在什麽地方?
- 歐力克(kè)斯智能灌膠機的10大優勢
- 灌膠機日常怎麽保養?
- 新能源汽車灌膠:防火阻燃
最新資訊(xùn)文章
您(nín)的瀏覽曆史









